二手 ESEC 3088iP #9091727 待售
网址复制成功!
单击可缩放
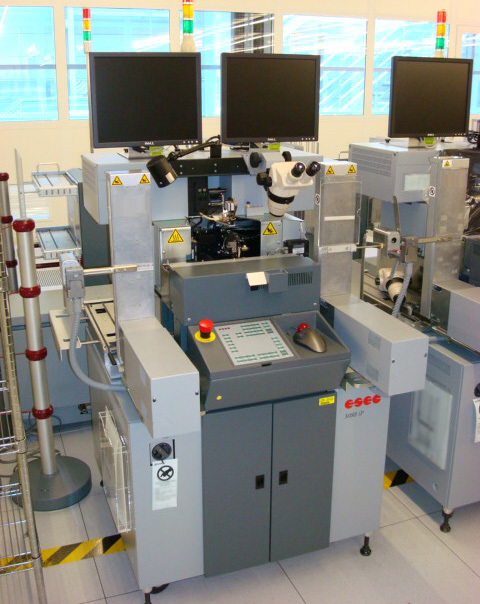

ID: 9091727
优质的: 2002
Wire bonder
Flying bondhead:
Bond placement accuracy: ± 3.5 μm (3 Sigma)
Typical sprint UPH: (11) Wires / Second
Max. bonding area: 52 x 64mm / 2 x 2.5"
Indexer:
Process zone temperature: 50 to 300°C
Pre-bond / post-bond zone: 50 to 300°C
Process heater adapter blocks standard widths: 8/24/44 mm 0.31/0.95/1.73"
Pre / post-bond heater plates standard widths: 8/25/45/69 mm 0.31/0.98/1.77/2.72"
Wire:
Spool diameter: 50.8 mm / 2"
Spool width: 25.4 to 50.8 mm / 1 to 2"
Windings: single or multi layer
Gold wire diameter:
Standard: 17.5 to 50 μm / 0.7 to 2.0 mils
Capillary:
Length: 11.1 mm / 0.437"
Diameter 1.58 mm / 1/16"
PRS System:
Chip alignment:
Std. mode: 10 ms
Adv. mode: 30 ms
Leadframe alignment single mode: 10 ms
Finger alignment: ≤ 6 ms/ finger (304 ld)
Looping:
Flat loop: 125 to 250 μm < 8 μm, 5 to 10 mils < 0.3 mils
Standard loop: 125 to 200 μm < 8 μm, 5 to 8 mils < 0.3 mils
Typical data TSOP:
Wire length: 2 - 3 mm (140 μm 6 μm)
Typical data QFP:
Wire length: 3 - 4 mm (200 μm 8 μm)
Max. wire length: 7 mm / 280 mils
Wire straightness: < 1% of wire length
Magazine handling:
Magazine gripper with self-adjusting clamps
Buffer capacity magazine platform:
(4) Magazines for QFP 84 L/F
Loading / Unloading platform dimensions:
Depth: 227mm / 8.93"
Width (adjustable): 120mm / 4.72" to 260mm / 10.23"
2002 vintage.
ESEC 3088iP是一种全自动粘合器,为微电子和光电组件提供先进的模具和线键连接能力。该平台专为大批量生产而设计,采用先进的晶圆级封装和模具连接技术,实现亚微米精度和极精确的线对模具、线对线和模对模键接头。ESEC 3088I P的设计高度重视债券,认识到质量和可靠性始于债券一级。3088 IP结合了超声波楔形粘合(UWB)和热压(TCB)技术,使用户能够为每个特定应用选择最佳粘合选项。线束头可实现25 µm以下的线下直径,而模具连接系统可实现5 µm ±以下的可重复放置精度。3088I P还配备了模块化摄像头系统,提供视觉对准和键后质量保证。可调节的照明方向、背光和弱光选项,以及可调节的变焦功能,使用户能够检查焊接球放置错误、缺少的特征以及粘结形成前后的其他潜在电路板缺陷。集成视觉系统还可以测量粘结长度、环路高度和环路面积直径,以保证质量后粘结连接。3088iP的VP 8000操作软件支持12英寸和6英寸450mm基板,可配置为堆迭卡和单卡。它提供了可编程的分配速度和输送机速度,以实现最佳的生产吞吐量,以及可定制的直径、线距和螺距计数。附加的编程功能使用户能够轻松调整线对齐、环路位置、线绝缘和卷曲高度。ESEC 3088 IP促进了各种晶片级封装和模具附着应用,包括翻转芯片模具附着、MEMS封装和翻转片上磁带项目。其先进的技术和用户友好的功能使其能够满足最苛刻的生产要求,达到每小时两万个债券的速度,精度公差可达2 µm ±。ESEC 3088iP是一种用途广泛、可靠且高效的粘合剂,旨在实现完整的微装配。
还没有评论