二手 JEOL JEM 2010F #293585832 待售
网址复制成功!
单击可缩放
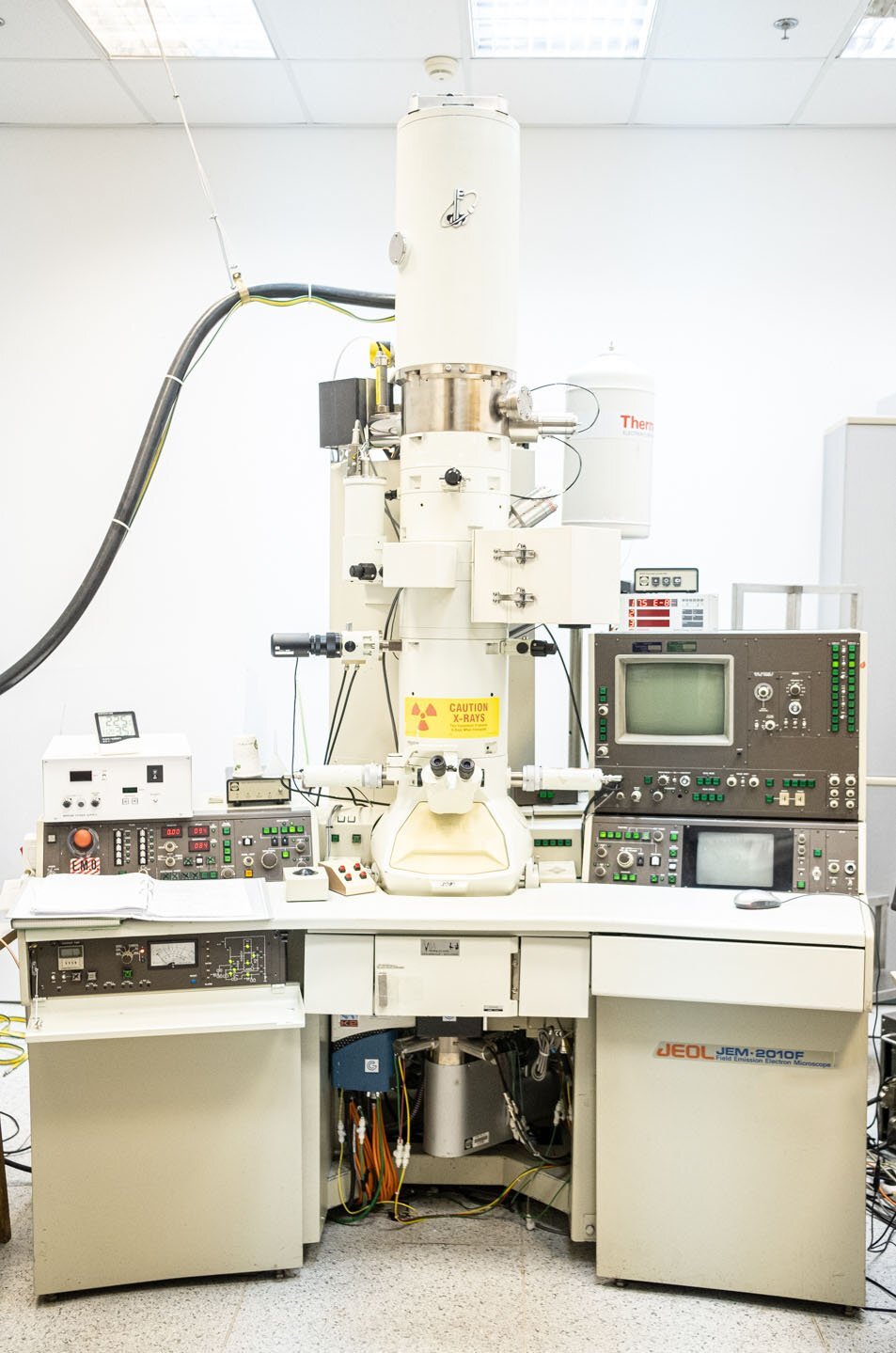





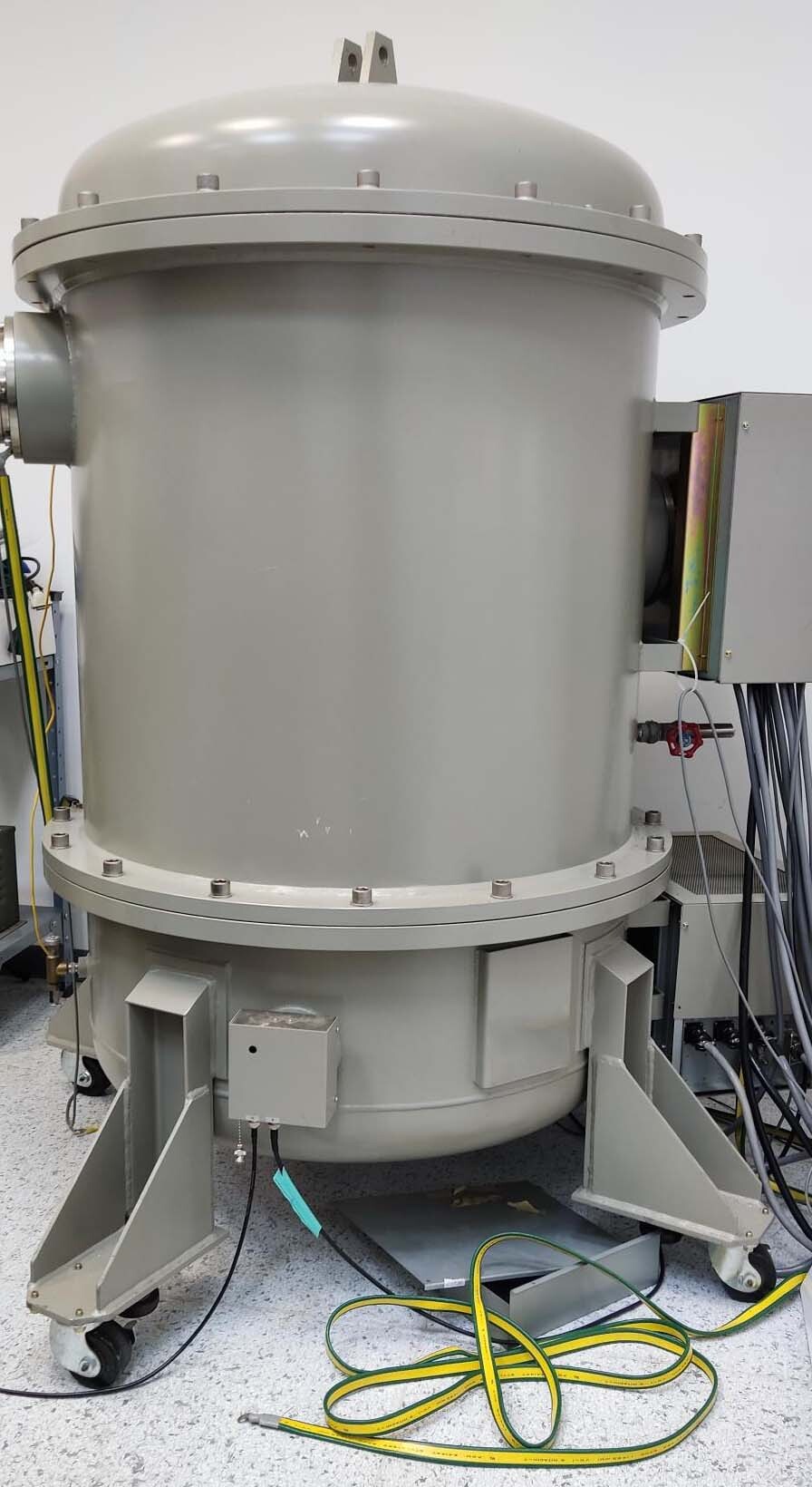









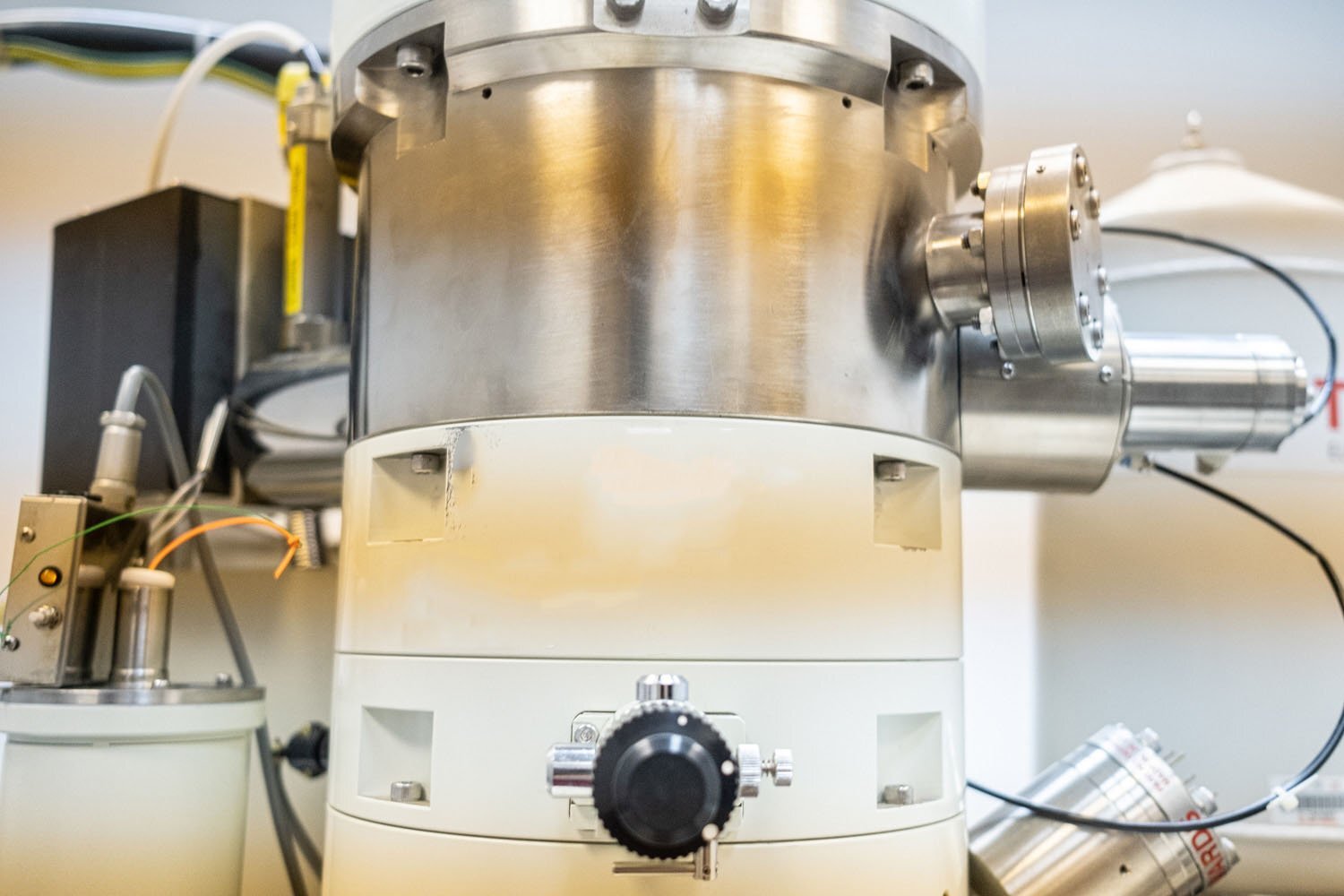































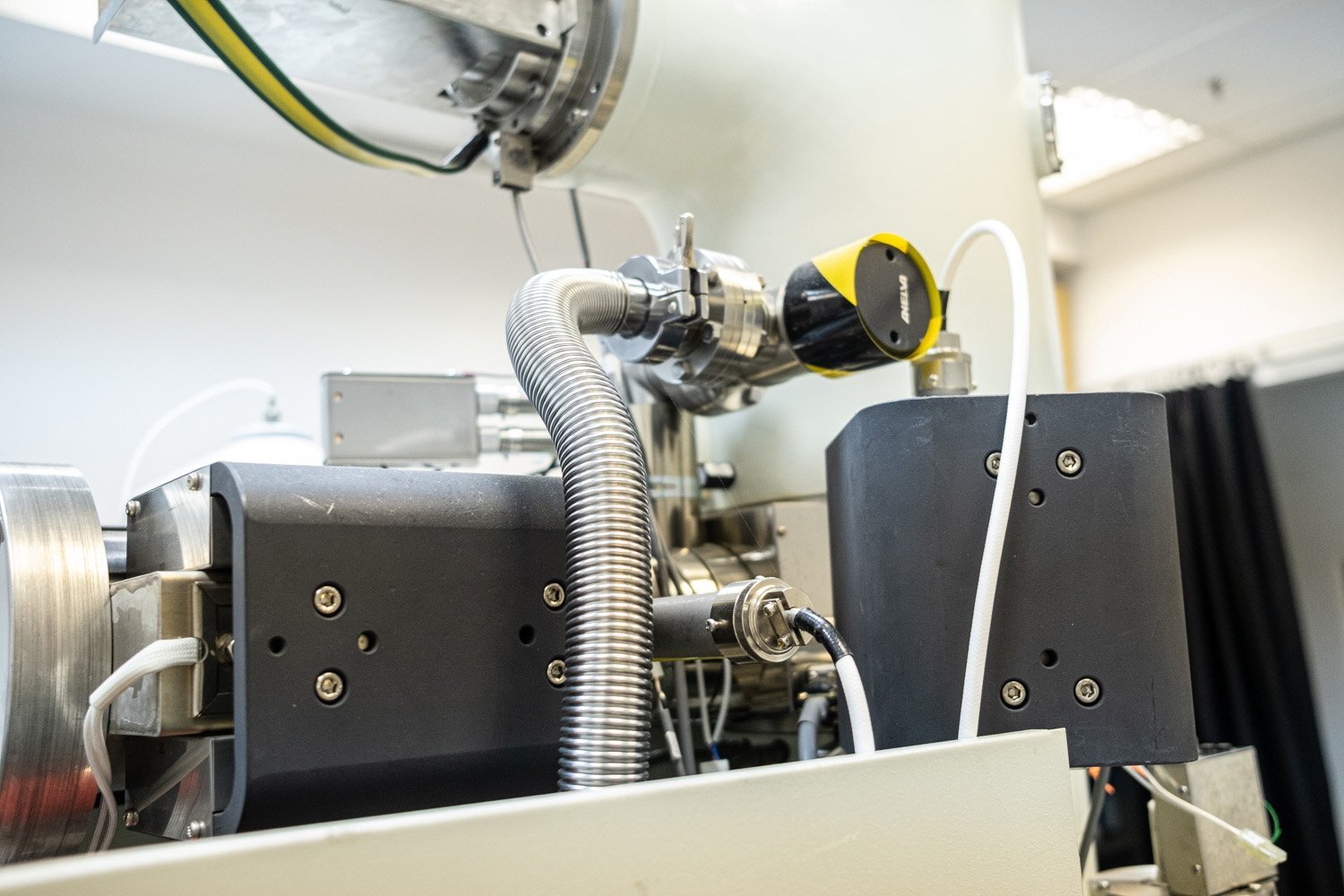





















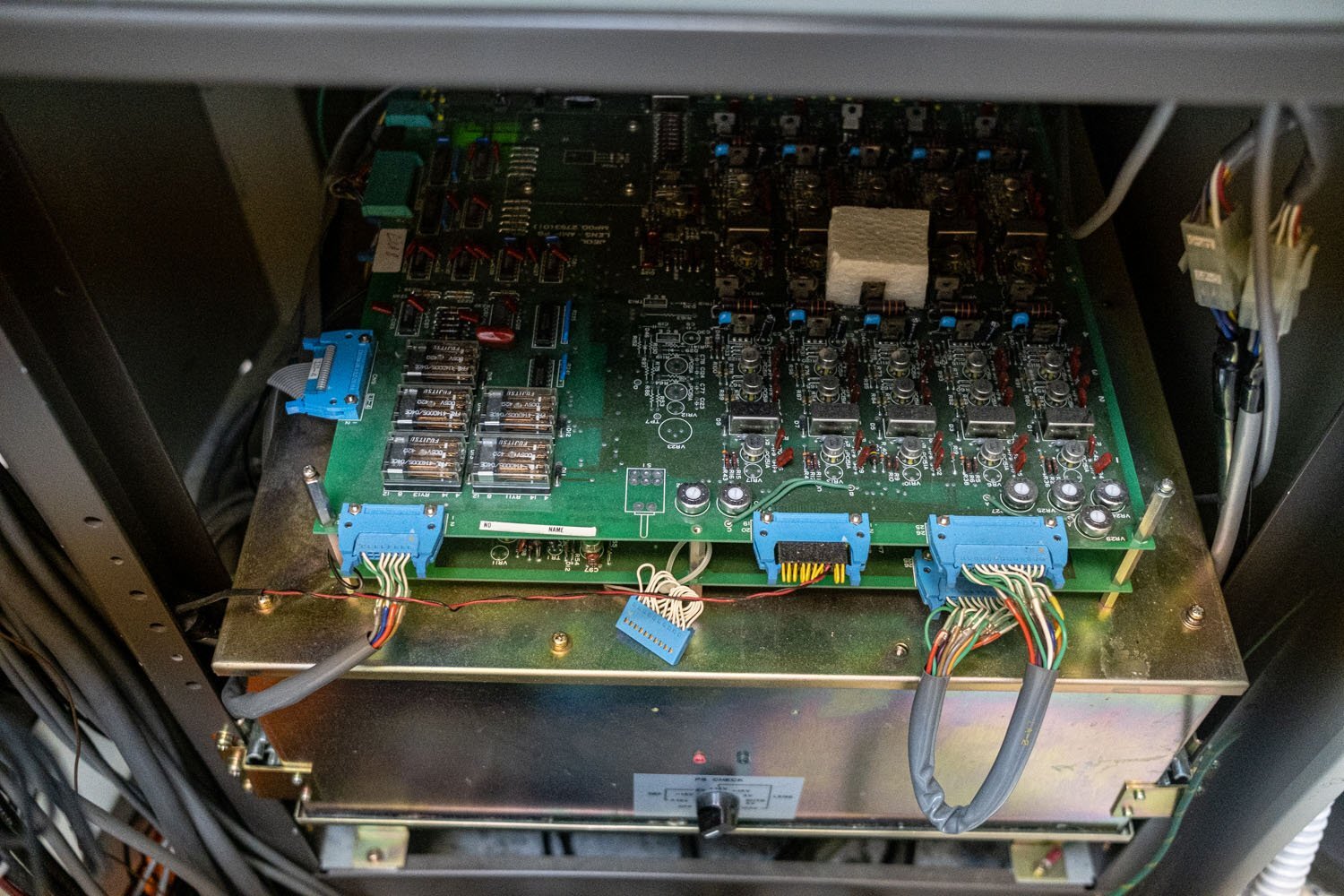

















































ID: 293585832
Scanning Transmission Electron Microscope (STEM)
UHR Objective pole
Spherical aberration coefficient: 0.5 mm
Point-point resolution: 0.19 nm
Information limit: 0.1 nm
Energy resolution: 133 eV
SiLi detector
Resolution imaging
Collection angle: 0.13 Sterad
Take off angle: 20°
Phase resolution: 100 rad
JEOL Bi-Prism electron holographic measurements
Medium and low magnifications
EDS
EELS
K2
Power supply: 80 kV-200 kV.
JEOL JEM 2010F是一种先进的扫描电子显微镜(SEM),为研究人员、技术人员和行业专家提供亚微米特征级分析所需的工具。针对各种材料分析、微米级观测、缺陷分析和自动化操作对JEOL JEM-2010F进行了优化。JEM 2010F提供非常高分辨率的小样品成像,包括干燥和液体形式的材料。它能够分析一系列样本大小,从1微米孔径到200微米范围。通过JEM-2010F提供的大深度景深,可以以高达150,000X的高放大倍率捕获详细图像。高分辨率和景深相结合,可以检测到表面和地下的高对比度特征,如夹杂物、腐蚀、晶界和晶体缺陷。JEOL JEM 2010F还提供了一系列自动化显微镜功能,这些功能通过先进的软件技术得以实现。JEOL的自动化功能JEM-2010F为用户提供许多有用的选择,包括结合从分析的多个阶段获取图像,同时处理多个样本,以及使用各种工具来控制扫描过程。JEM 2010F还包括一系列样本和分析类型的高级信号分析选项。JEM-2010F提供的信号分析工具可用于分析信号模式、色度变化和热图,以极小的尺度检测材料微观结构的变化。JEOL JEM 2010F的性能因其智能控制设备(ICS)而进一步提升。ICS结合了人工智能,以确保系统每次运行都能正常工作,并优化成像。智能单元还允许全自动测量场景,为用户提供更快的成像速度、更高的吞吐量和更一致的结果。总之,JEOL JEM-2010F是一种先进的SEM,具有多种功能,可实现实时成像,并具有丰富的详细信息。自动成像和信号分析功能提供了一系列功能强大的工具,可确保高质量的结果,而智能控制机器则可在每张图像中提供可靠性和精确度。
还没有评论