二手 VACUUM SYSTEMS TECHNOLOGY / VST TFSP-840 #293602592 待售
网址复制成功!
单击可缩放
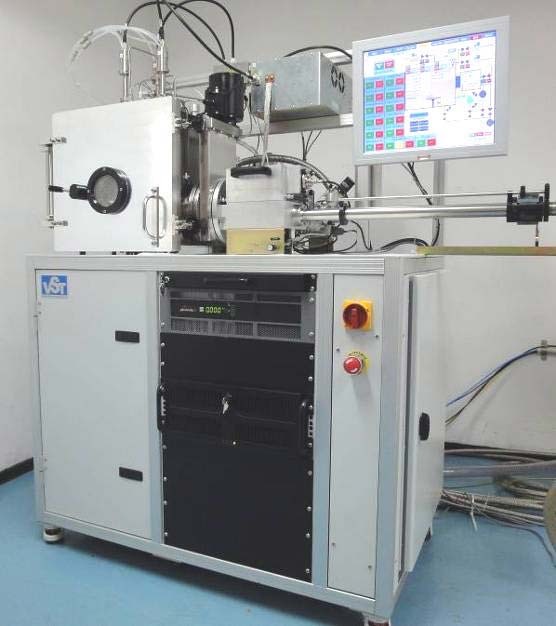







ID: 293602592
Sputtering system
Ultimate vacuum pressure: 3x10^-7 Torr
Base pressure: 1x10^5 Torr
Pirani gauge, 100 to 1x10^-5 Torr
Maximum allowable leak rate: <1x10^-9 mbar L/sec (Helium)
Vacuum pumping system
PLC Controlled power switching boxes
DC Blocked filters
Substrate holder
PLC / PC Computer control
Targets:
Titanium Tungsten: (Ti) 10 (W) 90 %
Copper (Cu)
Silicon Nitride (Si3N4)
Sputtering mode:
DC / DC Pulsed
RF
Combination of RF and DC
Chamber:
High grade stainless steel, water cooled, SS 304L
3-Ports
RF Shielded view port, 4"
Pumping port
Load lock chamber:
Loading sample holder, Up to 6"
EDWARDS nXDS10 Dry pump:
Pressure: 8x10^-3 Torr
Nominal pumping speed: 10 m³/hrs
EDWARDS EXT75iDX Turbo molecular pump:
Pumping speed: 61 L/sec
Compression ratio N2: >1x10^11
Ultimate pressure: 5x10^-8 mbar
Nominal rotational speed: 90,000 rpm
Air cooling
Sputtering sources:
Source dimension: MAK, 4"
Mounting feedthrough: Quick coupler, 0.75"
Target specifications:
Target diameter: 4"
Target mounting: Magnetic
Magnetic materials
Magnet design:
Type: Nd/Fe B
Configuration: Balanced/Unbalanced
Operation specifications:
DC Max power: 3000W
RF Max power: 1200W
Cathode voltage (Volts): 200-1000V
Discharge current (Max amps): 7 amp
Cooling water:
Flow rate 1.0 gpm
Vacuum interlock
High voltage switch
Chamber switch
Load-lock switch
Dry air pressure switch
Water flow switches
Substrate temperature
Emergency stop
Electrical overload protection
Gas line:
Gas / MFC
Ar / 1-100 SCCM
N2 / 1-50 SCCM
O2 / 1 – 50 SCCM
Maximum beam current:
25 to 35% of discharge current
280mA (Ar @ 1A)
350mA (O2 @ 1A)
Beam energy (Mean): 50 to 180eV (~60% of Anode voltage set point)
Max discharge power: 300W (200W Continuous)
Discharge voltage range:
Ar: 50 to 300V
O2: 100 to 300V
Discharge current range: 0.2 to 1A (Mark I + Ion Source Controller)
Max operating pressure: 1 x 10^-3 Torr (0.13Pa)
Gas use: Inert Gases, O2, N2 and other reactive gases
Typical gas flow range: 2-20sccm
Ion beam neutralization: Filament cathode
Ion beam size (at opening): 1.1 in (28mm) Diameter
MFC 20 sccm
Power supply:
RF Power supply: 13.56 MHz, 600 W
DC Power supply: 1500 W.
VACUUM SYSTEMS TECHNOLOGY/VST TFSP-840是一种多功能溅射设备,可提供坚固一致的溅射性能。该系统配备了多种腔室配置,可容纳多种工具和配件。该装置能够处理薄基板和柔性基板,以便在各种材料上进行可靠和可重复的沉积。VST TFSP-840采用最先进的两室设计,带有一个隔离的装载室和一个单独的加工室。装载室的设计是为了减少颗粒污染,并允许快速,容易样品加载。每个腔室都配有2英寸的粗加工泵以营造稳定、低压的环境,确保高效运行。装载室采用锁载门,最大限度地减少空气中的污染物,确保平稳运行。在工艺室内,VACUUM SYSTEMS TECHNOLOGY TFSP-840配备了八个阴极和一个动力基板旋转机构。每个阴极可以独立调整功率设置和溅射目标。高性能基板旋转机构在整个基板上提供一致甚至均匀的沉积。顶部安装的溅射枪使机器容易被容器化,用于大面积样品的原位处理。该TSFSP-840配备了一系列附件,包括改装的基板支架、外部基板加热、滚筒运输工具、板载升降机/直接检修臂和安全锁,以确保安全和不间断的操作。新增的功能使TSFSP-840成为工业应用的理想选择。由于其广泛的特点,TFSFP-840提供了一致的和可重复的结果,确保了可靠的薄膜沉积在各种底物。该资产提供精确的过程控制和可靠的可重复性能,非常适合高吞吐量应用程序。而且,该型号人性化的触摸屏界面允许简单方便的操作。
还没有评论