二手 AMAT / APPLIED MATERIALS Centura 5200 #9198283 待售
网址复制成功!
单击可缩放


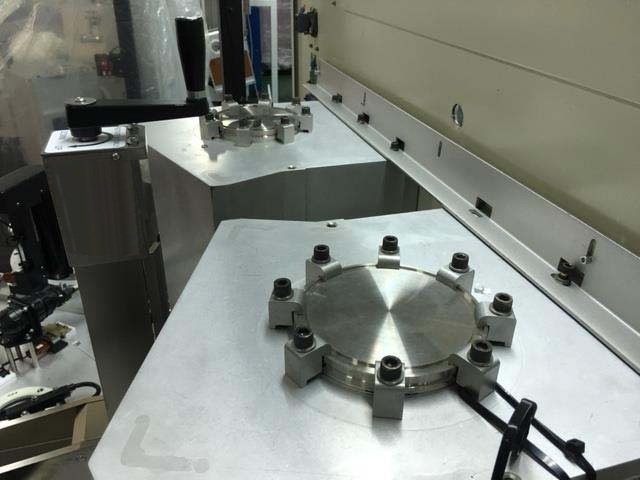



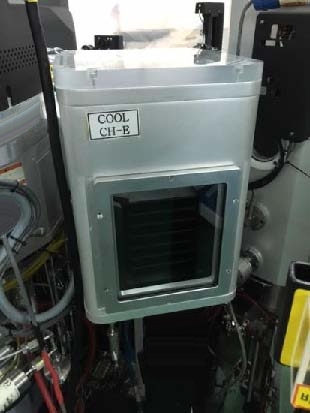



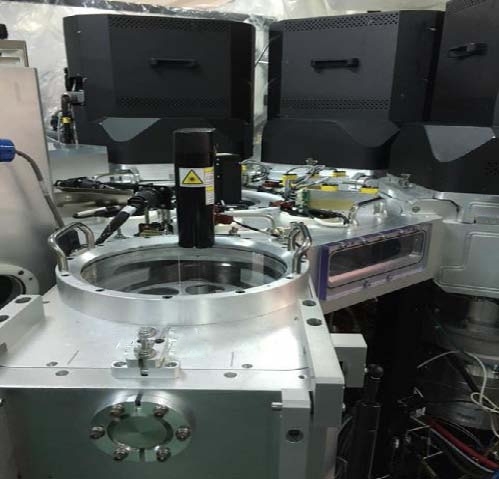

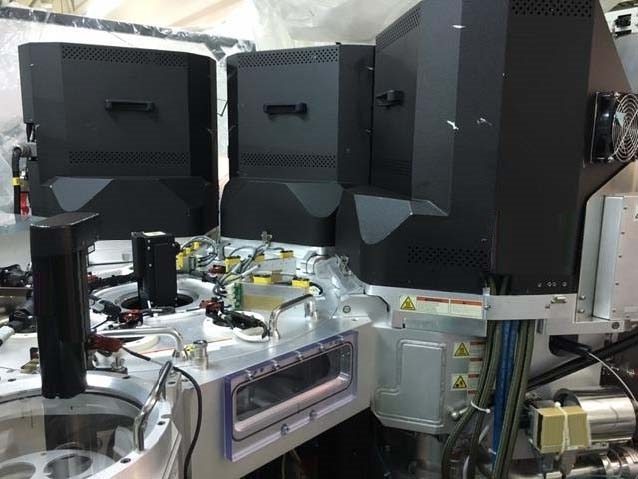



















ID: 9198283
晶圆大小: 8"
优质的: 2000
HDP CVD System, 8"
Wafer shape: SNNF
Chamber configuration:
Chamber A: HDP Ultima TE process chamber
Chamber B: HDP Ultima TE process chamber
Chamber C: HDP Ultima TE process chamber
Chamber E: Multi cooldown chamber
Chamber F: Orient chamber
Loadlock configuration:
Loadlock type: Narrow body
Auto rotation
Cassette type: 200mm
Mapping function: FWM
Vent type: Variable speed
Fast vent option
Mainframe configuration:
Buffer robot type: HP+
Buffer robot blade: Ceramic blade
Status light tower: RYG
Remote monitor: Table mount
Includes:
SMC Thermo chiller INR-498-001B
RF Generator type: ETO RF System
Standard gas panel
With (3) sets gas pallet
LEYBOLD MAG2000 Turbo pump
Gate valve: NC
Electrical configuration:
Line voltage: 208V
Full load current: 320 A
Frequency: 50/60Hz
2000 vintage.
AMAT/APPLIED MATERIALS Centura 5200是一种先进的等离子体反应器,设计用于生产电子微器件。作为等离子体增强化学气相沉积(PECVD)反应器,AMAT Centura 5200比其他沉积机理有多项优势,如化学气相沉积(CVD)或热CVD。APPLIED MATERIALS Centura 5200系统的主要部件是等离子室、电源、真空泵、玻璃器皿、计算机控制的过程室以及支持硬件。等离子体腔室是一个真空腔室,包含一种过程气体,如氮气或氙气,以及少量的前体气体,如硅烷。气体的这种组合是产生室内等离子体的原因。电源提供产生等离子体所需的能量。Centura 5200中的玻璃器皿包括沉积板、基板级、出口管以及其他各种有助于调节工艺区尺寸和温度的组件。基板阶段是沉积过程所必需的,并将基板(晶圆或转移基板)固定到位。沉积板是将气体引导至基板上所需位置所必需的。出口管道从等离子体室输送废气。该工艺室是一个封闭式容器,带有计算机控制的温度传感器和预处理气流控制器。气体流动控制器调节沉积过程所需的气体流动,并在腔室内保持恒定温度。AMAT/APPLIED MATERIALS Centura 5200使用空气基机理产生等离子体,导致沉积速率高,基板上沉积物均匀性好。AMAT Centura 5200内的真空泵用于维持等离子体腔内的压力,也用于疏散沉积过程的任何副产物。这确保了腔内的过程气体不受任何杂散原子或来自反应的粒子的影响。最后,APPLIED MATERIALS Centura 5200的支援硬体设计为反应堆的运作提供整体支援。这包括空气阀、压力传感器、温度传感器和关闭设备等组件。这些组件通过允许调整气体流动、气体压力和温度以及其他参数来监测和控制反应堆的运行。总体而言,Centura 5200 PECVD反应堆是制造多种微型装置和产品的可靠和高效的系统。它将先进的部件和计算机控制的工艺室结合在一起,确保以尽可能最有效的方式实现最高质量的沉积。
还没有评论